行业资讯

FIB-SEM扫描电子显微镜应用领域及案例分析
聚焦离子束扫描电子显微镜(Focused Ion Beam-Scanning Electron Microscope,简称FIB扫描电镜)双束系统是指同时具备聚焦离子束(FIB)和扫描电子显微镜(SEM)功能的系统。通过与相应气体沉积装置和纳米操纵仪以及各类探测器和可控样品台及其他配件相结合,使其成为集微区成像,处理和分析于一体、操纵为一体的分析仪器在物理,化学,生物,新材料,农业,环境以及能源等许多领域都有着广泛的应用。

FIB-SEM扫描电镜案例分析
1、微纳结构加工
FIB扫描电镜系统不需要掩膜版就能直接刻画出或沉积到GIS系统下所需要的图形,使用FIB系统已能够在微纳米尺度上制备复杂功能性结构,内容涉及纳米量子电子器件、亚波长光学结构、表面等离激元器件和光子晶体结构。采用合理方法,不但能实现二维平面图形结构的绘制,而且即使在复杂的三维结构中也能进行制备。
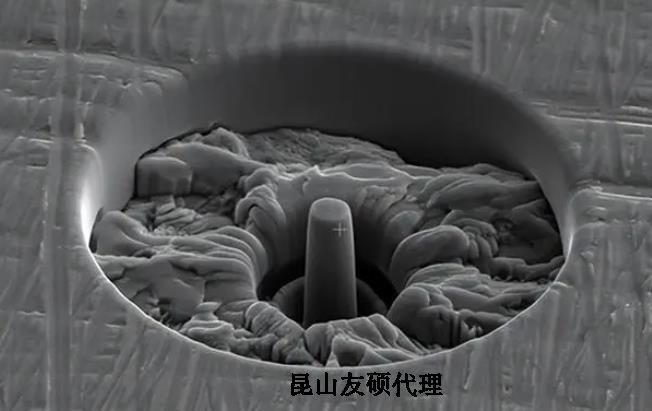
2、截面分析
利用FIB溅射刻蚀功能可定点切割试样并观测横截面(cross-section)来表征截面形貌尺寸,还可配备与元素分析(EDS)等相结合的体系来分析截面成分。普遍应用于芯片, LED等失效分析方面,普通IC芯片在加工时存在问题,采用FIB可迅速定点地分析缺陷产生的原因并改进工艺流程,FIB系统已成为当代集成电路工艺线必不可少的设备。

3、TEM样品制备
TEM样品的制备方法可以分为非提取法与提取法两种。非提取法就是在预减薄后的试样中,用定点FIB处理感兴趣区来制备电子透明观测区域,见下图。
采用提取法提取TEM样品时,最终减薄工艺流程与能否获得优质TEM照片有直接联系。若将抽取的试样整体变薄易产生试样弯曲问题。并且利用能增强试样自支撑性H型或者X型对试样进行减薄,可以避免试样弯曲问题。下图是用H型减薄方法制备TEM样品SEM照片。
4、三维原子探针样品制备
对原子探针样品的制备要求与TEM 薄片样品很接近方法也类似。首先选取感兴趣的取样位置,在两边挖V 型槽,将底部切开后,再用纳米机械手将样品取出。转移到固定样品支座上,用Pt 焊接并从大块样品切断。连续从外到内切除外围部分形成尖锐的针尖。最后将样品用离子束低电压进行最终抛光,消除非晶层,和离子注入较多的区域。
5、芯片修补与线路修改
利用FIB中溅射功能可以切断某处连线,也可以利用它的沉积功能可以把某地原先没有连接到的地方连接到一起,这样就可以改变线路连线的方向,可以发现,诊断出线路中存在的误差,并能直接对芯片中的误差进行校正,减少研发成本并加快研发进程,由于它可以免去原形制备及掩模变更所需时间及成本。

6、三维重构分析
三维重构分析的目标主要靠软件来控制FIB的逐层切割与SEM成像的交替实现,最终实现三维重构。将FIB三维重构技术和EDS高效地结合起来,研究者可以从三维空间中表征材料结构形貌和组成等信息;与EBSD相结合,可以表征多晶体材料在空间状态中的组织,取向,晶粒形貌,尺寸,分布信息。
想要了解污污视频网站产品信息请来电咨询400-1500-108



